過去幾年,臺積電的CoWoS技術因滿足AI芯片對算力及能效的需求,迅速成為先進封裝的代名詞。然而,近期由英偉達工程師提出的“CoWoP”技術卻突然被推上風口浪尖,甚至有人預言它將改寫PCB產業版圖,挑戰CoWoS的領先地位。 CoWoP究竟是短暫的話題炒作,還是足以改變半導體封裝版圖的下一個顛覆力量?
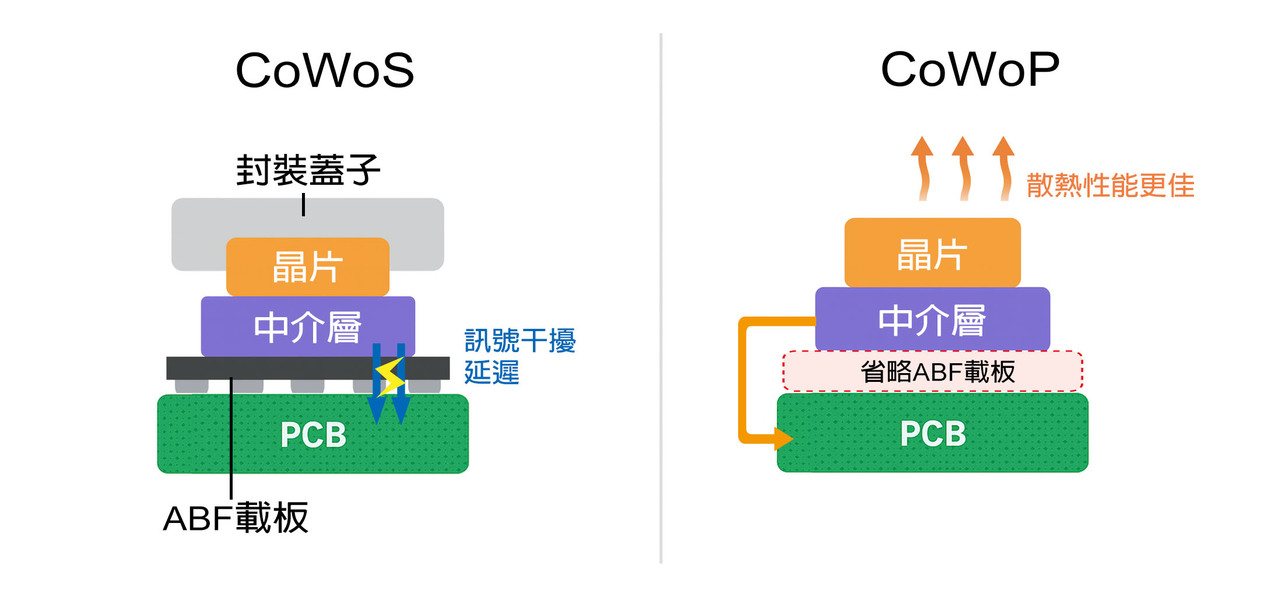
CoWoP是什么?為何比CoWoS更具優勢?
臺積電CoWoS(Chip-on-Wafer-on-Substrate)先進封裝技術為AI戰場上兵家必爭,正當巨頭們為了產能斤斤計較之際,一份英偉達內部外流的報告顯示,英偉達正在測試新一代CoWoP(Chip on Wafer on PCB)技術,計劃與臺積電CoWoS雙線推進,預計在2026年10月下一代Rubin GPU系列的GR150芯片同時采用CoWoP與CoWoS兩種封裝技術。
這項創新CoWoP先進封裝技術,是先將裸芯片(Chip)通過微凸點倒裝到硅中介層(Wafer)上完成芯片與硅基板的高密度互連,然后將整個芯片在硅基板組件用PCB的類載板(mSAP)制程直接焊接在PCB主機板,省略掉CoWoS需要封裝基板(如ABF/BT載板)的工序,PCB在此不僅承擔電連接,還通過HDI或MSAP/SAP等工藝在板上形成精細的重分布層(RDL),保證信號完整性與功率分配。
與CoWoS相比,CoWoP將封裝基板與PCB一體化,實現更薄、更輕、更高帶寬的模塊設計,同時充分利用大尺寸PCB產線的高產能與成熟工藝,CoWoP用成熟大面板PCB替代昂貴的ABF/BT載板封裝基板,不僅大幅降低材料與制造成本,還可加速PCB產線的高產能與短交付周期實現更快的量產,同時通過PCB上直接集成芯片、硅中介層和多層HDI/MSAP重分布層來減少封裝層級,實現更薄更輕的板卡一體化設計,并在同一塊板上完成多至10余層、30μm級線寬/線距的高速互連,兼具高帶寬、低延遲與設計靈活性。
消息一出不僅引發市場對CoWoS是否會被CoWoP取代的討論,甚至動搖到在臺積電的技術藍圖中將接班CoWoS的CoPoS(Chip-on-Panel-on-Substrate)上場時間。
CoPoS是臺積電為了解決CoWoS量產瓶頸而推出的下一代封裝技術,結合CoWoS與FOPLP(Fan-Out Panel Level Packaging),以方形的面板RDL層取代原本圓形的硅中介層,雖然互聯密度不如原CoWoS的硅中介層,但面板面積大,可利用率高,可有效解決產能問題,成本也更低,適合大規模量產。
臺積電預計于2026年在采鈺建置首條CoPoS(方形晶圓封裝)實驗線,并進一步規劃至2028~2029年在嘉義投資量產廠,主要聚焦AI與高效能運算領域。
市場歡聲雷動,幾家歡喜幾家愁
報告一出,引起資本市場一陣騷動,包括巨集科技、深南電路、鵬鼎控股等大陸PCB廠股價飆漲,臺廠點名臻鼎-KY旗下鵬鼎公司可望受惠,股價同樣迎春風,國際投行也對y英偉達的這項技術變革產生高度興趣。
摩根大通研究報告指出,CoWoP的潛在優勢包括簡化系統結構,通過減少傳輸損耗提高資料傳輸效率,確保NVLink互連更高的范圍;更好的熱管理性能和更低的功耗;降低每代產品都在上升的基板成本;潛在減少一些后端測試步驟。
摩根士丹利的研究顯示,采用CoWoP的目標則為解決基板翹曲問題;在PCB上增加NVLink覆蓋范圍而無需在芯片和PCB之間設置基板;實現更高的散熱效率而無需封裝蓋子;以及消除某些封裝材料的產能瓶頸。
摩根大通認為,CoWoP的出現對ABF基板廠商顯然是負面消息,因為基板附加值可能會大幅減少或完全消失,更復雜、精細節距的信號路由將轉移到RDL層,而高端PCB層承擔封裝內路由步驟。
另一方面,CoWoP為PCB廠帶來重大的機遇,性能與主機板高電流/電壓要求之間的平衡是阻止PCB實現真正基板規格的主要挑戰,mSAP是在實現25/25微米更精細線/間距尺寸方面最佳的PCB技術,但仍遠低于ABF的亞10微米線/間距能力。未來具備先進mSAP能力以及基板/封裝技術的公司將更有優勢。
一旦CoWoP技術能如期推進,摩根士丹利點名包括臺積電、欣興、臻鼎-KY、華通等擁有mSAP制程能力的供應商將受益,接下來或許還會有更多的PCB廠跟進。
技術難度待克服商業化量產挑戰大
不過,CoWoP的前途似乎并非一片光明。摩根大通指出,這項技術存在關鍵挑戰。目前只有蘋果采用mSAP或SLP PCB技術,但其節距尺寸更大,PCB板面積更小,因此將此技術擴展到具有更高載流能力的大型GPU仍具技術與運營的挑戰,CoWoP中期商業化的概率較低。
摩根士丹利認為,技術的轉換不僅涉及制程工藝的改變,還將影響整個供應鏈的配置,以臺積電目前CoWoS良率已接近100%的情況下進行技術切換存在不必要的風險,考慮到Rubin Ultra的量產時程,時間點上不合商業邏輯且風險太高,因此推估Rubin Ultra仍將沿用現有的ABF基板技術,而非轉向CoWoP。
天風國際證券分析師郭明錤以蘋果投入類載板SLP研發耗時4年為例,其間蘋果、材料商、制造商與設備商合作,共同解決研發與量產問題,這不只是單一技術開發,而是整個產業生態升級。現在英偉達要將CoWoP導入SLP的挑戰遠勝蘋果,在沒有具體的實際測試結果前,CoWoP要量產并用于Rubin Ultra是過于樂觀的預期。
郭明錤并提到臺積電另一個次世代封裝技術CoPoS。他說,CoWoP在理論上可以改善傳輸效率并簡化供應鏈,但CoPoS要解決的是很實際的生產效率問題,因此從商業化的角度,CoPoS的優先順序理應高于CoWoP,而在實務上,要在一年內同時導入兩個重大創新但未經實證的技術的風險相當高。
臺PCB廠對于CoWoP取代CoWoS持保留態度,認為以mSAP制程的CoWoP取代IC載板的可能性非常低,因為這涉及整個產業鏈的技術制程都必須大幅提升,以現階段載板技術成熟,價格也合理,就終端客戶來說,看不到急需改變的理由,預期CoWoP要取代現有的CoWoS時間還很久,CoWoP能否獲得客戶青睞采用仍是未定之數。
IC載板廠景碩認為,先進封裝如CoWoS結構仍將是未來五年的市場主流,短期內不會被取代;即便玻璃基板或新型CoWoP架構提出,也只是長期技術藍圖,不會突然沖擊既有載板應用。


